IC封装出现缺货的4大原因
芯片的爆发式需求正在冲击IC封装供应链,导致大多数元件出现缺货。许多的IC封装工厂已经满负荷运转,据悉这种局面将持续到2018年。IC封装供不应求,这四大因素都能要了封测厂的命?
IC需求的意外爆发正在波及半导体封测供应链。
对芯片需求的不断上升正在冲击IC封装供应链,导致某些类型的封装、制造能力、引线框和一些设备的短缺。
IC封装供不应求的局面今年早些时候就开始出现了,自那时起,问题愈演愈烈,到了第三季度和第四季度,供求严重失衡,现在看来,这种局面将持续到2018年。
出现这种局面有若干原因,最主要原因在于IC需求意外爆发,因此客户需要更多的IC封装产能,但是,IC封装工厂已经满负荷运转,无法满足多种封装类型的需求。
除了IC封装之外,电子板块的其它产品品类也在这次所谓的“繁荣或超级周期”中面临供应短缺局面。全球最大的半导体封装与测试(OSAT)巨头先进半导体工程公司(ASE)首席运营官TIen Wu表示:“这次究竟是一次超级周期,还是我们之前从未见过的内在扩展?在这个超级周期中,供应不足的情况不绝于耳,包括存储、OLED、被动元件等等。甚至在贴片机等半导体设备方面也存在交付时间拉长的问题。之所以出现这种情形,一方面是由于产能供应有限,另一反面是需求将在很长的一段时间内维持强劲。”
大多数元件出现缺货的原因显而易见。比如OLED,苹果和三星两家智能手机巨头几乎吞噬了OLED屏幕的所有产能。尽管需求不断上升,DRAM供应商却一直不愿增加产能,导致DRAM成为今年涨价的急先锋。NAND产品则是由于供应商生产工艺正从平面型NAND向3D NAND转型,良率问题导致供应不足。
相比之下,集成电路封装的问题更为复杂,而且涉及多个产品市场。
集成电路封装行业的工厂利用率很高,但全球200毫米晶圆bumping制程的产能存在严重短缺。在晶圆bumping工艺中,焊球或铜柱在晶圆上形成,在晶粒与基板之间提供电互连。
200mm晶圆bumping产能不足影响了智能手机芯片级封装(CSP)和射频前端模块等产品的供应。
而且,由于其他原因,四扁平无引脚(QFN)封装和晶圆级封装需求量大增,导致供应紧张。
对QFN的需求导致引线框(leadframes)的交付时间更长,引线框是用于QFN封装类型的关键组件。而且,封装设备需求也比预期的要强。
当然,并不是所有封装类型都供不应求。但是总体来说,整个2017年半导体封测的需求一直很强劲,并且将一直持续到2018年。TechSearch InternaTIonal总裁Jan Vardaman表示:”每家封测工厂都处于满产状态,这段时期是封测工厂产能利用率最高的一段时间。”
不消说,供不应求会影响向客户的交付时间。 “这也会影响那些试图向市场推出新产品的公司,如果他们的供应受到限制,可能会损害他们的收入,”Vardaman说: “现在最大的问题是,供不应求的局面会持续多久?我想,谁都无法给出正确的答案。”
这些趋势令客户担忧。提供IC封装和测试服务的封测厂正面临巨大压力。这些封测厂多年来资本不足,大多数供应商没有足够的资源来满足苛刻的客户群的各种需求。
本文主要研究了IC封装行业面临的主要短缺问题,如bumping产能、封装类型、引线框和设备等。
Bumping产能
2017年突然出现的繁荣周期让整个业界大吃一惊。比如,2016年年末,世界半导体贸易统计组织(WSTS)预测,2017年集成电路行业规模将比2016年温和增长3%。但是,这一年来,随着DRAM和3D NAND销售额的激增,WSTS已经多次上调IC市场销售的预测。根据最新的预测,该组织预计2017年半导体市场规模将达到4090亿美元,同比2016年大幅度增长20.6%,2018年,IC市场将继续将增长7%。
IC封装供应链的情况反映了芯片行业的需求前景。在这次超级周期中,封测厂们在2017年上半年目睹了传统的增长模式。
但是到了第三季度和第四季度,若干个板块的需求开始超预期增长。 STATS ChipPAC公司产品和技术营销副总裁Vinayak Pandey说:“当然,智能手机的需求一直都在。除了移动设备,汽车和网络的需求超出了我们的预期。”
需求大增导致封测厂商订单的激增。目前,封测厂商的工厂利用率平均都在80%以上,当然有很多类型的封测产能正在满负荷运转。 “封测厂商正在全负荷运转,”Pandey说。“如果有任何额外的需求,交货时间就会越来越长。”
产能的紧张表现在好几个方面,其中,最大的瓶颈是一种被称为晶圆bumping的成熟制造工艺,尤其是在200mm晶圆上。目前,Amkor、ASE、STATS ChipPAC等公司都提供晶圆bumping服务。
作为交钥匙服务的一部分,晶圆bumping直接在200mm或300mm晶圆上进行。bumping本身不是一种封装类型,它是一种在晶圆上形成微小的焊球或铜柱的制造工艺。
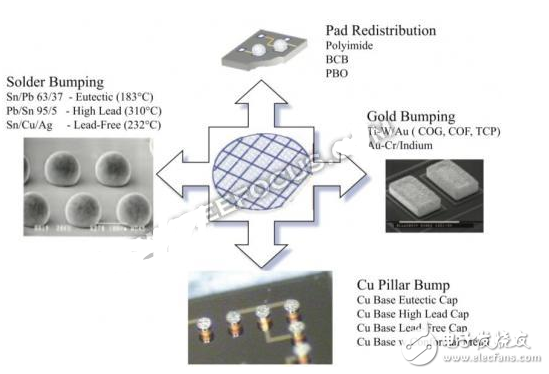
图1. 通用bumping技术
通过bumping,封测厂商可以开发出各种封装类型,比如CSP、扇出和Flip-chip BGA。CSP、扇入式和扇出式都属于晶圆级封装(WLP)。WLP是当IC还在晶圆上时就对其进行封装的一种工艺。
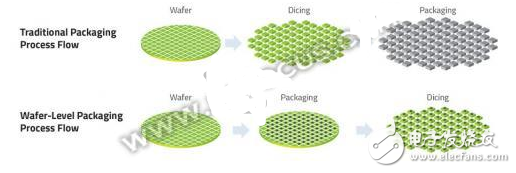
图2. 传统封装与晶圆级封装的流程对比
Flip-chip是一种互连方案,而不是一种封装类型。它广泛应用在应用处理器、图形芯片和微处理器中。
在Flip-chip中,在硅片上形成微小的凸块或铜柱。然后,将器件翻转并安装在一个单独的硅片或电路板上。硅片或电路板包括一些铜焊盘。 凸块或铜柱落在焊盘上,形成电气连接。
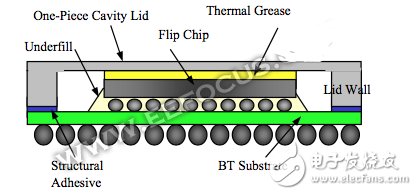
图3. Flip-Chip BGA封装
目前,OSAT厂商已经具备了充足的300mm bumping产能,但是令人惊讶的是,市场上200mm bumping的成熟产能严重短缺。
这个短缺有几个原因。 一段时间以来,集成电路产业对200mm晶圆的芯片需求巨大,导致200mm晶圆厂产能严重短缺。
200mm晶圆业务的爆发拖累了整个供应链,当然也影响了OSAT。但200mm bumping产能不足主要是由于模拟和射频器件的巨大需求。Amkor公司bump业务高级副总裁Kevin Engel表示:“RF前端模块需要更多的凸块以及越来越多产品从其他封装类型迁移到WLCSP导致了对200mm晶圆bumping产能的激增。”
实际上,200mm bumping产能的短缺已经导致了CSP和RF前端模块的供应短缺。射频前端模块由手机中使用的关键射频元件组成。

图4. 标准CSP
模拟/射频芯片制造商正在争夺200mm晶圆bumping产能。以前,这些供应商选择了一种使用了被称为球滴的传统技术的封装类型,这种工艺是在芯片的I/O上形成焊球,焊球的尺寸大小为从150μm到200μm。
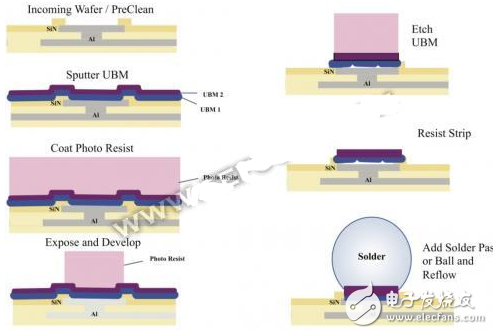
图5. 球滴工艺
“当你缩小管脚时,你需要同步缩减焊球的大小。焊球的尺寸有一定限制,“STATS ChipPAC的Pandey说。“所以模拟芯片供应商都想缩小封装,并把更多I/O集成在器件上。突然之间,他们再也不能用焊球了,他们需要一个更小的凸块。。”
结果,许多模拟/射频芯片制造商都从球滴技术转移到电镀bumping工艺上,这样可以形成更小的管脚,但是需要更多的工艺步骤,比如电镀。Pandey说:“工艺转换带来的挑战在于,球滴工艺是一个相当快的过程,但电镀工艺却比较耗时。所以就对产能产生了挑战。”
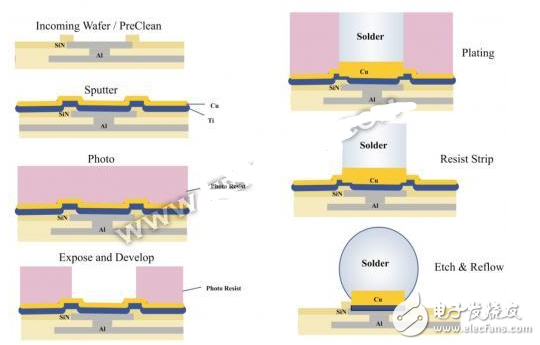
图6. 电镀凸点工艺
未来一段时间内,200mm晶圆bumping的产能预计仍将供不应求。过去,OSAT厂商一直不愿增加200mm bumping的产能,但是现在,有些厂商正在改变方向,并计划在2018年增加更多产能。
在2019年,模拟/射频芯片制造商可能会从电镀凸块迁移到铜柱凸块。今天许多数字芯片也在使用铜柱凸块,这意味着未来这种技术可能会面临疯狂的争夺。
某些封装类型供不应求
如上所述,当前市场上的CSP和RF模块供应紧张。其它封装类型的需求也很高。TechSearch的Vardaman表示:“晶圆级封装的强劲增长仍在持续,我们还看到系统级封装的增长,以及汽车IC封装的增长。”
扇入和扇出型等WLP封装的需求非常强劲。 Amkor公司的Engel说:“晶圆级封装与bumping的情况类似。 行业内200mm和300mm的整体产能紧张。目前稍有缓和,但供求关系失衡将在2018年达到顶峰,到时挑战性会更大。”
大部分需求都集中在传统扇出封装,即嵌入式晶圆级BGA(eWLB)上。 新一代高密度扇出型封装的需求也在不断攀升中。目前,台积电的扇出型封装技术已经被苹果采用。日月光、Amkor、STATS ChipPAC等公司也正在推出新一代扇出工艺。
令人惊讶的是,QFN-一种较旧但可靠的封装类型-需求也很火爆。分析师认为,英飞凌、恩智浦、Microchip、Silicon Labs、意法半导体和TI是推动QFN需求的主要动力。
QFN和四方扁平封装(QFP)属于引线框封装类型。引线框是由封装引线和外框的金属框架。硅片被绑定在框架上,引线通过细线连接到管脚上。
STATS ChipPAC公司的Pandey表示:“QFN是目前最便宜的封装类型,QFN虽然便宜,但它仍然允许你做一些布线工作。”
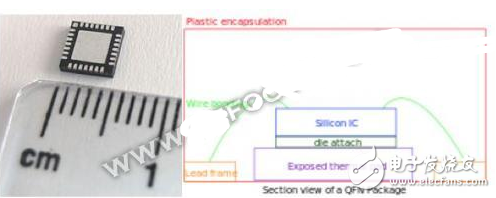
图7. QFN封装
QFN的驱动力主要来自两个市场 - 汽车和物联网(IoT)。 他说:“我们现在开始发现,QFN正在逐渐走向供需失衡,QFN的需求无处不在。”
更加雪上加霜的是,三星在最新的智能手机上大量采用了QFN封装。此外,三星智能手机更多采用了WLP封装,但是由于上一代智能手机出现了各种各样的问题,三星决定选择更加可靠稳定的QFN取代WLP封装,以保证手机的可靠性。
相比之下,苹果在其最新的智能手机中使用了更多的WLP,包括扇入和扇出两种封装。
同时,QFN的强劲需求正在影响用于制造这些封装的组件供应,即引线框。Amkor公司引线框产品高级总监Prasad Dhond表示:“QFN需求强劲,但在可控范围内。自2017年第一季度以来,部分供应商的引线框出现供应紧张局面。由于产能短缺,使用特定粗糙处理的引线框的交付时间一再拉长。由于铜原料短缺,其他引线框架供应商已经推迟了交货时间。”
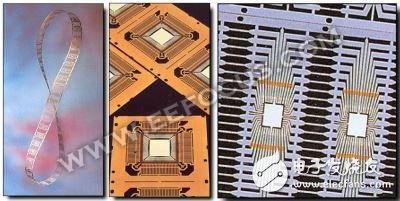
图8. 引线框例子,精密冲压、高质量电镀、光刻
引线框的困境
可以肯定的是,引线框业务也正在发生一些变化。SEMI表示,目前市场上有40多家引线框供应商,其中包括一些规模在1000万美元至4000万美元范围内的小型供应商。较大的引线框供应商包括ASM太平洋科技、昌华、海星DS、三井、新光和SDI。
SEMI表示,总体而言,2017年IC封装的引线框单位出货量预计同比2016年增长10%。SEMI的分析师Dan Tracy表示:“可以肯定地说,2018年以后,引线框的单位出货量的增长率会降低到低至中等的个位数。”
引线框业务利润较低,并且经历了一些动荡时期。以下是该行业最近发生的一些事件:
2016年,全球最大的引线框供应商住友金属矿业(Sumitomo Metal Mining)因为利润率下滑以及面临来自中国的激烈竞争的双重压力而退出了这一行业。 去年,台湾的昌华收购了住友的主流引线框产品。另一家台湾供应商Jih Lin则从住友公司购买了功率半导体引线框产品。
2017年,引线框供应商无法获得足够的用于制造IC封装引线框所需的铜合金材料。
然后,日立、科比、三菱和其他铜合金供应商已经将大部分生产从引线框产品转移到了更高利润率的连接器产品上。
总而言之,引线框供应商和他们的客户都将面临产能不足的挑战。SEMI公司的Tracy说:“用于引线框的铜合金存在供应问题。所以引线框制造商和他们的客户都面临更长的交付时间。”
引线框供应商需要大量的铜合金材料来制造IC封装的引线框。不过,最近,OSAT厂商对精细间距的QFN封装产生了强烈的需求,这种封装对铜的需求更少。 “总体而言,半导体封装消耗的铜合金数量一直在下降,”Tracy说。 “虽然整体引线框出货单位仍然在增长,但更小、更薄的QFN封装的趋势会导致铜合金消耗量更少。”
综合考虑这些问题,2017年,引线框供应商一直备受压力。“从2016年底开始,我们看到引线框市场出现回升。当进入2017年第二季度时,我们发现市场需求突然迅速增加,”ASM太平洋科技集团首席运营官兼执行副总裁Stanley Tsui说,这家公司是设备、引线框和其他产品的供应商。Tsu也是ASM太平洋科技公司物料业务部门的首席执行官。
大概在2017年第二季度,铜材料供应商开始将他们的产品从引线框转移到连接器产品,导致引线框的交货时间延长。“这种举动导致整个供应链非常紧张。”Tsui说。“该行业开始争夺原铜产能。”
引线框的传统交货时间为三到四周。分析师指出,到了2017年年中,引线框的平均交货时间大约延长到了10到12周,这种局面导致了市场的“恐慌性买入”。
“在第二季度和第三季度开始的时候,我们的交货时间已经延长到了12到16周,有些个别产品的交付时间是20周,那是用在一个独特工艺上的产品,“Tsui说。“当我们进入第四季度时,市场平静了一些。现在,我们已经回到了6-8周的水平,有些产品是4到6周。”
目前,引线框市场情况比较复杂。Mitsui High-tec的法律小组经理Kenji Okuma在一封电子邮件中表示:“由于汽车应用的推动,对引线框的需求比以前要高。Mitsui是目前全球最大的引线框供应商,生产各种引线框架,包括用于各种应用的超细间距产品。”
引脚框和其他产品供应商SDI公司营销和销售部副总裁James Cheng表示:“总体来说,引线框目前的供求情况比较紧张。”
Cheng和其他人认为,更大的问题是铜合金材料的供应。SEMI表示,从供应商角度来看,引线框厂商获得铜合金的交货期是40到50天,连接器厂商是30到40天。
Cheng说,日本和德国的供应商生产的铜材料质量更高,但是这些产品“供应非常紧张并难以获得”。“它们需要更长的交货期。同时,供应商也提高了价格。”
中国也生产铜合金。虽然中国的供应商有足够的产能,但是它们的质量有时候不符合标准。 他说:“中国的低端铜供应商无法达到一定的质量要求。”
设备方面的情况
除了某些封装类型和引线框供应紧张之外,OSAT厂商还担心用于制造IC封装的设备的交付时间。
一些设备的交付时间还算正常,但是有一些设备的交付时间正在延长。比如,全球最大的电焊机供应商Kulicke&Soffa最近宣布电焊机的交货时间为五周,比正常情况延长了两周。
不过,K&S发现,用于功率集成电路的楔形键合机订单猛增。溅射设备和其他系统的交货时间也正在延长。
那么,年底将至,2018年的情况会如何演变?预测未来是困难的,但封装供应链的短缺预计将至少持续到2018年上半年。
目前,供应商们正在采取观望的态度。ASM太平洋科技公司的Tsui说:“在下一波供应短缺到来之前,这段时期大家都比较冷静。业界也有时间冷静下来,消化库存。然后,我们会再次等待下一次供应短缺带来的红利。”
